闵行供应善仁SiC碳化硅烧结银膏
-
¥1900.00
及时发货
交易保障
卖家承担邮费
由于现有封装技术的限制,特别是芯片与基板的互连技术,例如银浆、聚合物材料,软钎焊等互连技术由于焊料合金的低熔点、环氧树脂的低温分解等原因,使其不能在高温环境下可靠工作,导致限制电力电子系统性能和可靠性的瓶颈从半导体芯片转移到了封装技术上来。
② 进行预加热干燥,用于排除烧结银中的有机气体等挥发物,然后在高温下进行无压或压力辅助烧结,主要烧结工艺参数有:升温速率、烧结温度、烧结压强、烧结时间和气体环境等;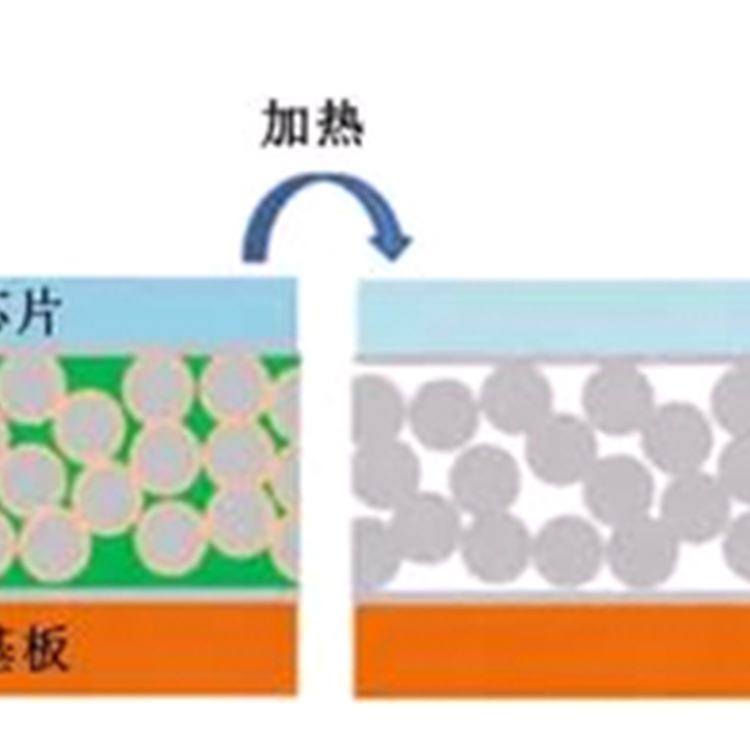
另外,善仁新材研究院发现:较大面积的互连会导致较差的互连质量,其原因是增加的互连面积阻止了有机成分被燃尽,会导致更高的的孔隙率,针对这种现象,善仁新材提出了两个解决方案: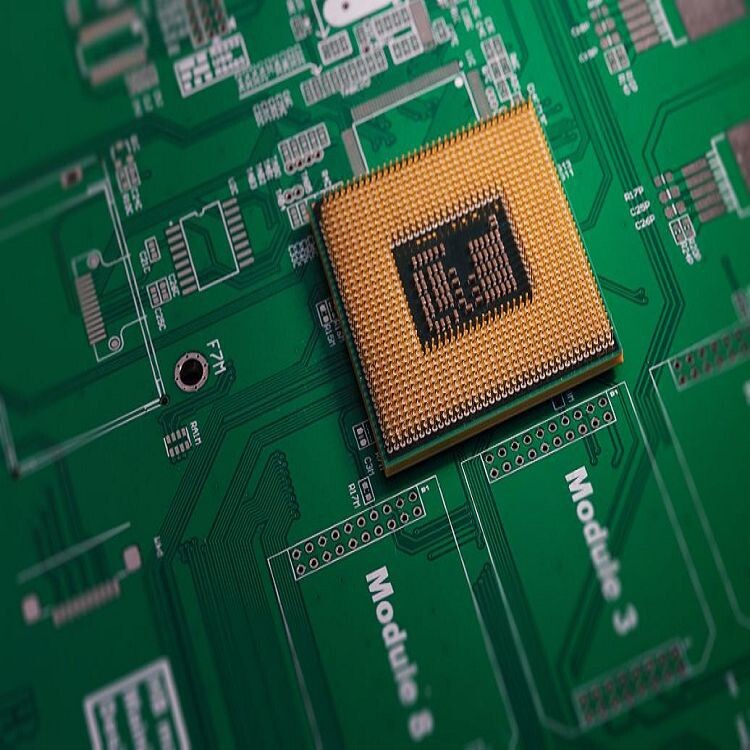
纳米烧结银互连层的孔隙研究
善仁公司统计了在不同时间和温度下孔隙率情况。发现孔隙率的大小和芯片的大小有很大的关系,采用无压纳米烧结银AS9375封装5*5mm的小芯片,几乎无孔隙。对于大于5*5mm的芯片,空隙率会在3-8%之间。孔隙主要由小孔和中孔组成,在250℃烧结时,空隙会很少。
善仁新材研究院通过各种测试得知:纳米烧结银的互连层的空隙大小和空隙率高低和烧结温度,升温速率,保温时间等有密切的关系。
烧结纳米银导热率及孔隙关系
孔隙对于热传导性能的影响会很大,善仁新材发现:纳米烧结银热流密度分布不均匀,有孔隙的地方会使得周围的热流密度变低,并且随着孔隙率的增加,等效热导率依次减少。空隙率越低,导热系数越高,空隙率越高,导热系数越低。