无锡订制SiC碳化硅烧结银膏
-
¥1900.00
及时发货
交易保障
卖家承担邮费
② 进行预加热干燥,用于排除烧结银中的有机气体等挥发物,然后在高温下进行无压或压力辅助烧结,主要烧结工艺参数有:升温速率、烧结温度、烧结压强、烧结时间和气体环境等;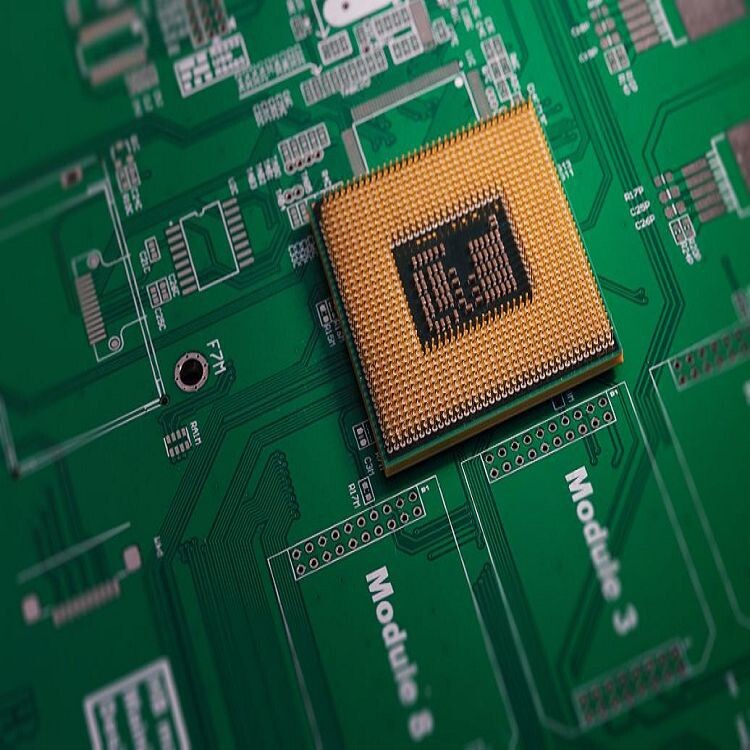
③烧结完成后形成SiC-Cu基板纳米烧结银互连层。可以看到,善仁新材的纳米银烧结互连层是碳化硅功率器件封装的关键结构单元,属于薄层结构,其厚度范围一般为20~50μm。SiC芯片和Cu基板表面可以通过镀银、金等烧结工艺提升其互连层的连接强度。
纳米烧结银互连层的孔隙研究
善仁公司统计了在不同时间和温度下孔隙率情况。发现孔隙率的大小和芯片的大小有很大的关系,采用无压纳米烧结银AS9375封装5*5mm的小芯片,几乎无孔隙。对于大于5*5mm的芯片,空隙率会在3-8%之间。孔隙主要由小孔和中孔组成,在250℃烧结时,空隙会很少。