目前尽可能从机械方面集成电力电子系统所有的功能,碳化硅、氮化镓(射频/非射频)模块封装也向着更高的集成度方向发展。
个难题:烧结银膏技术
在芯片与基板的连接中,传统有基板焊接功率模块中,焊接连接往往是模块上的机械薄弱点。
烧结层厚度较焊接层厚度薄60-70%,热传导率提升5倍,国内外诸多厂商把银烧结技术作为第三代半导体封装的核心技术,银烧结技术成为芯片与基板之间连接的选择.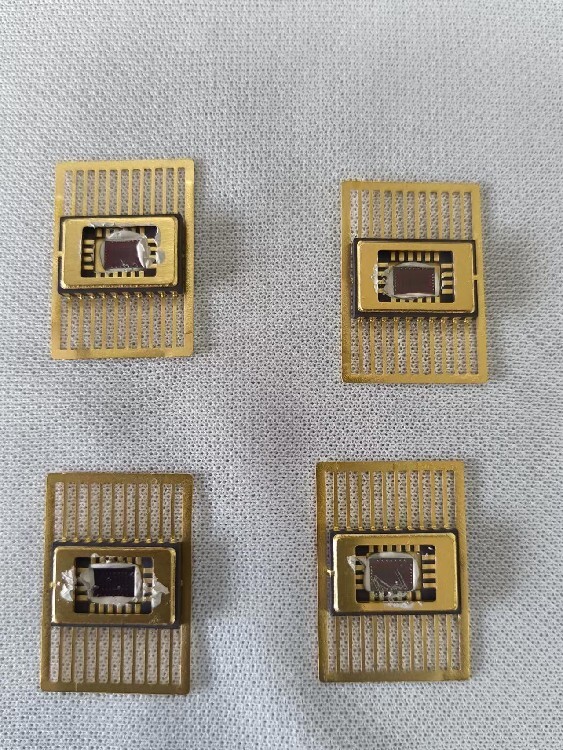
同时在此基础上开发出双面银烧结技术,将银带烧结在芯片正面代替了铝线,或取消底板将基板直接烧结在散热器上,大大简化了模块封装的结构。
芯片连接采用银烧结合金而不是焊接,烧结连接熔点更高,这意味着在给定温度摆幅下连接的老化率将低得多,功率模块的热循环能力可增加5倍。
目前SHAREX开发的银烧结技术已经由微米银烧结进入纳米银烧结阶段,纳米加压烧结银与市面上原来售卖的微米烧结银技术相比: