成都高可靠SiC碳化硅烧结银膏厂家
-
¥1900.00
纳米烧结银做为SiC芯片封装的互连层研究总结
IGBT功率器件被广泛用于新能源电车、车载逆变器上,做主要的控制元器件,而以SiC为代表的第三代半导体材料所制成的功率器件能够承受500℃左右甚至更高的温度,比Si小近千倍的导通电阻,多20倍左右的开关频率等性。
由于现有封装技术的限制,特别是芯片与基板的互连技术,例如银浆、聚合物材料,软钎焊等互连技术由于焊料合金的低熔点、环氧树脂的低温分解等原因,使其不能在高温环境下可靠工作,导致限制电力电子系统性能和可靠性的瓶颈从半导体芯片转移到了封装技术上来。
③烧结完成后形成SiC-Cu基板纳米烧结银互连层。可以看到,善仁新材的纳米银烧结互连层是碳化硅功率器件封装的关键结构单元,属于薄层结构,其厚度范围一般为20~50μm。SiC芯片和Cu基板表面可以通过镀银、金等烧结工艺提升其互连层的连接强度。
纳米烧结银互连层的工艺改进
善仁新材研究院比较了加压微米烧结银和无外加压力纳米烧结银,通过实验发现纳米尺度下的银具有比微米尺度下更高的烧结驱动力,避免了压力烧结条件下对芯片和基板中造成缺陷和裂纹等现象,并发现了烧结温度和烧结压强的增加会降低烧结银的孔隙大小,AS9375无压烧结银的纳米银互连层的结合强度可达45MPa。
烧结纳米银导热率及孔隙关系
孔隙对于热传导性能的影响会很大,善仁新材发现:纳米烧结银热流密度分布不均匀,有孔隙的地方会使得周围的热流密度变低,并且随着孔隙率的增加,等效热导率依次减少。空隙率越低,导热系数越高,空隙率越高,导热系数越低。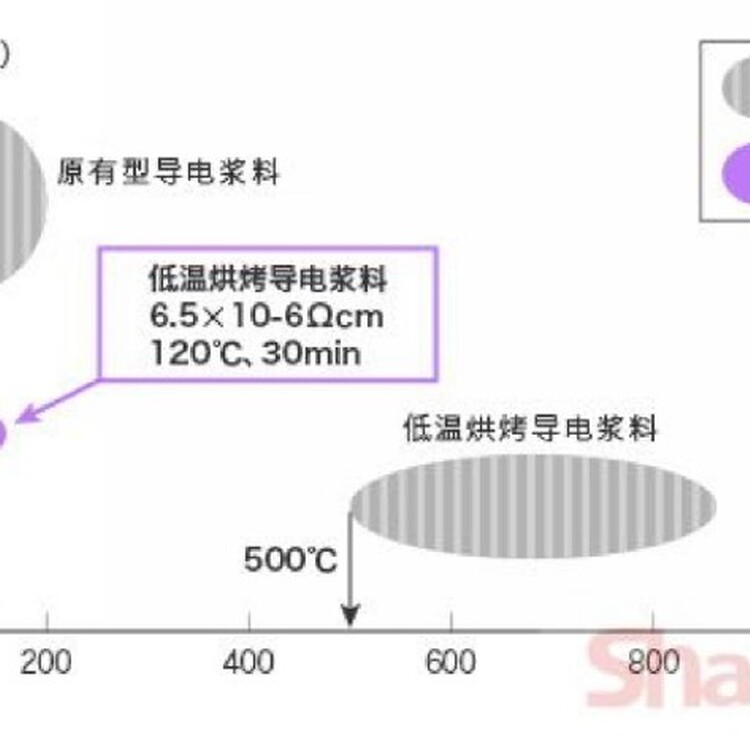
随着无铅化的推进,善仁新材的纳米烧结银时替代焊锡膏作为连接材料的候选材料之一,特别是在混动和电动汽车,高铁,航空航天,太阳能,深井石油开采等需要在200度恶劣环境下的各种工作应用,必将成为主流的互连材料之一。