DTS碳化硅芯片焊片湖南DTSDTS+TBC工艺
-
¥1200.00
DTS+TCB预烧结银焊盘工艺提高功率器件通流能力和功率循环能力
在新能源汽车、5G通讯、光伏储能等终端应用的发展下,SiC/GaN等第三代半导体材料水涨船高,成为时下火爆的发展领域之一。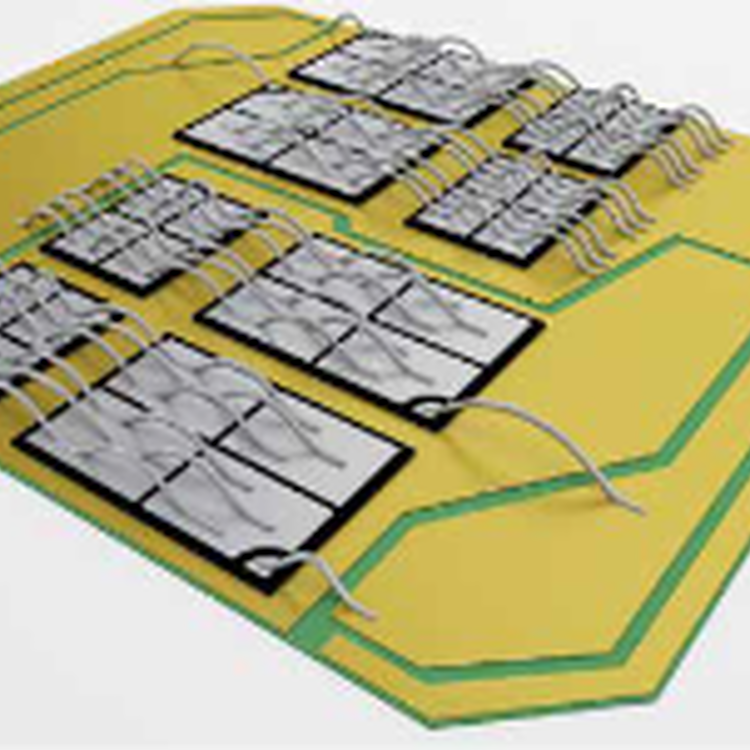
目前烧结银技术主要用于对可靠性和散热高要求的市场,在引线框架制作上除了要提供高可靠度的镀银品质以符合烧结银的搭接技术以外,由于烧结银的膜厚只有20um-50um,不像传统的锡膏搭接方式可通过锡膏量的调整补正搭接面平整度不佳造成的搭接问题,烧结银的搭接技术对于搭接处的公共平面度要求公差只有20um,对于这种复杂的折弯成型式技术是一大挑战。
众所周知,在单管封装中,影响器件Rth(j-c)热阻的主要是芯片、焊料和基板。SiC芯片材料的导热率为370W/(m.K),远IGBT的Si(124W/(m.K)),甚至超过金属铝(220W/(m.K)),与Lead Frame的铜(390 W/(m.K))非常接近。而一般焊料的导热率才60 W/(m.K)左右,典型厚度在50-100um,所占整个器件内部Rth(j-c)热阻之权重,是不言而喻的。
善仁新材的GVF9700无压预烧结焊盘和GVF9800有压预烧结焊盘,为客户带来多重便利,包括无需印刷、点胶或干燥,GVF预烧结银焊片工艺(DTS+TCB(Die Top System +Thick Cu Bonding)可以将铜键合线和烧结工艺很好结合在一起,同时具有较高的灵活性,可以同时让多个键合线连接在预烧结焊盘上来进行顶部连接。
SHAREX的预烧结银焊片GVF9800(DTS+TCB(Die Top System +Thick Cu Bonding)是结合了烧结银,铜箔和其他材料的一种复合材料,由以下四个部分组成:具有键合功能的铜箔;预涂布AS9385系列烧结银;烧结前可选用临时固定的胶粘剂;保护膜或者承载物。
GVF预烧结银焊片(DTS+TCB(Die Top System +Thick Cu Bonding)和金,银,铜表面剪切强度都很大。