天津大港低温无压纳米烧结银
-
¥128000.00
AS9331的优点总给如下:
低温无压:银烧结技术是把材料加热到低于它的熔点温度,然后材料中的银颗粒聚集结合,并实现颗粒之间的结合强度。传统银烧结采用对材料或设备加压、加热直至形成金属接点的方法。然而,在半导体封装领域,这种加压技术的应用必然会碰到芯片破损或者产能不足的问题,因为客户在资本密集型的芯片粘接设备上单个自地生产。
提率:善仁新材的这一无压低温技术提高了生产效率,从传统银烧结技术每小时只能生产约30个产品上升至现在的每小时3000个。现在,凭借这一新的银烧结材料,第三代半导体封装得以实现高产能,高可靠性的产品。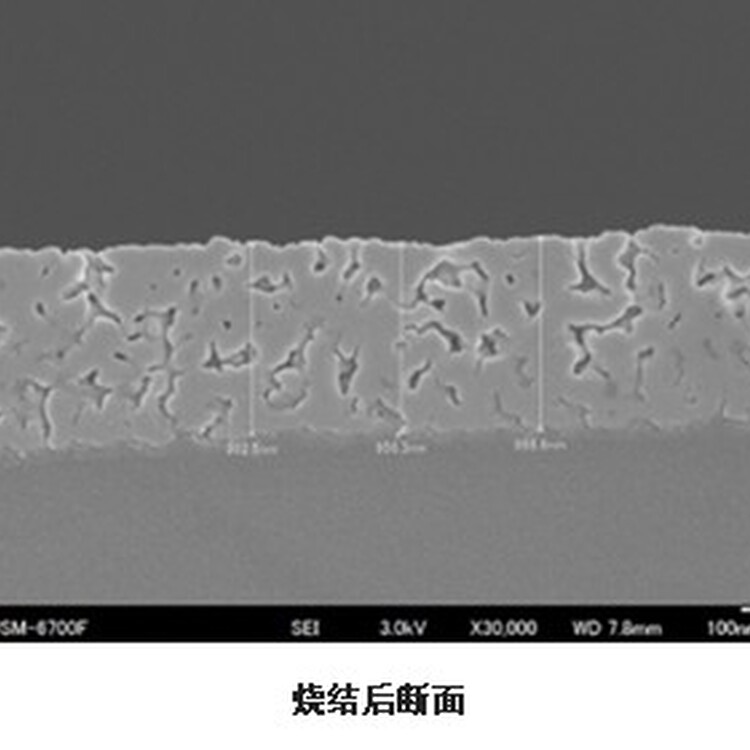
公司开发出了纳米颗粒技术平台,金属技术平台、树脂合成技术平台、同位合成技术平台,粘结技术平台等。在以上技术平台上开发出了导电银胶、导电银浆,低温烧结银,纳米银墨水,纳米银浆,纳米银胶,纳米银膏,可焊接低温银浆,可拉伸银浆,异方性导电胶,电磁屏蔽胶,导热胶等产品。
为了验证此策略,使用1200V/400A车用SiC功率模块的低应力封装工艺,此器件的烧结面积4.4 mm×4.0 mm,钼片厚度为1.5 mm,氧化铝衬底基板的厚度为1.2 mm。 两侧基板均采用AS9330低温无压银烧结技术以实现器件和钼片的互连,烧结后形成器件-基板组件和钼片-基板组件结构连接,烧结后两组组件的连接使用传统的高温焊料 Pb92.5Sn5Ag2.5。
以上连接工艺均在传统真空回流炉中完成。相比传统Si基功率封装模块,这种采用AS9330银烧结的SiC功率模块的热阻降低了40%,体积减小50%。由于烧结过程大面积基板的翘曲问题,SiC 基器件的源区焊接面并没有使用银烧结,考虑到器件源区连接界面接近SiC器件的结温,该界面处可能更容易发生失效,所以采用对低压辅助烧结或借助适当治具有助于增加该界面的稳定性,进而实现一次全银烧结。
二 双面冷却 SiC 功率模块的制造工艺
1印刷银焊膏
2贴片
3烧结银焊膏
4引线键合
5端子焊接
6放置焊片
7真空回流焊接
8塑封