传统钎焊料熔点低、导热性差,难以满足高功率器件封装及其高温应用要求。此外随着第三代半导体器件(如碳化硅和氮化镓等)的快速发展,对封装的性能方面提出了更为严苛的要求。AS9385有压银烧结技术是一种新型的高可靠性连接技术,在功率模块封装中的应用受到越来越多的关注。
烧结银技术的优势与特点
1.什么是烧结银技术
20世纪80年代末期,Scheuermann等研究了一种低温烧结技术,即通过银烧结银颗粒AS9385实现功率半导体器件与基板的互连方法。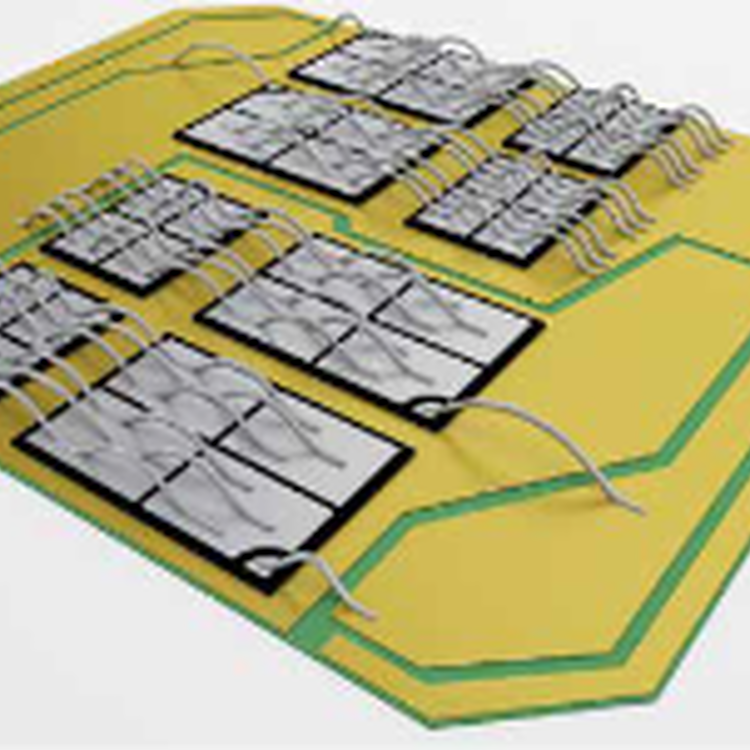
有压银烧结AS9385是一种新型的高可靠芯片粘接和键合技术,可确保无空隙和高强度键合,并具有的导热性和导电性。 该技术可以将器件的结温 (Tj) 低降至150℃。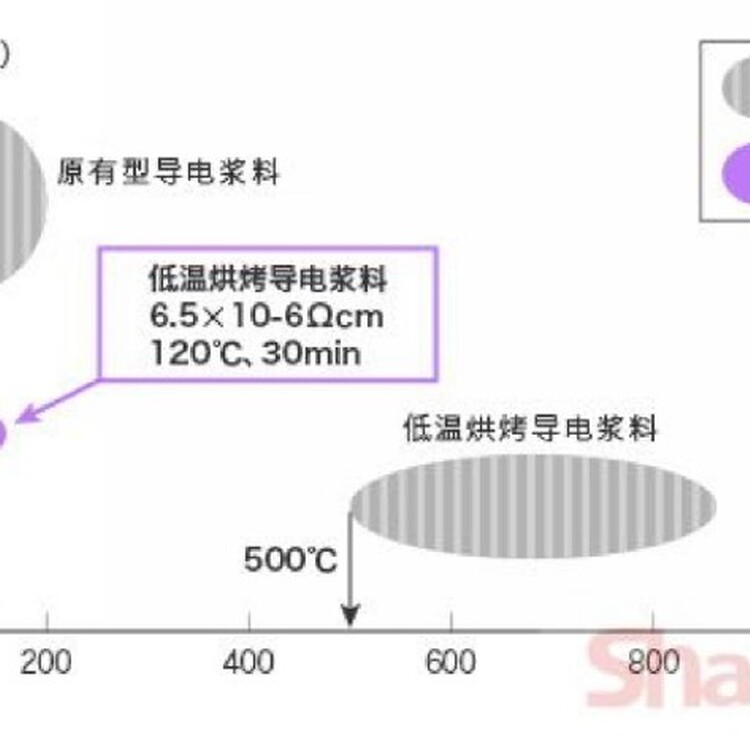
在这种烧结过程中,在适当的压力、温度和时间条件下,经过持续加热,有压烧结银AS9385由粉末形态变为固体结构。与传统焊接材料相比,这种技术产生的烧结键更可靠,能够提高器件的性能和寿命。
SHAREX的AS9385银烧结技术也被成为低温连接技术(Low temperature joining technique,LTJT),作为一种新型无铅化芯片互连技术,AS9385烧结银可在低温(<250℃)条件下获得耐高温(>700℃)和高导热率(~240 W/m·K)的烧结银芯片连接界面,具有以下几方面优势:
烧结得到的连接层为多孔性结构,孔洞尺寸在微米及亚微米级别,连接层具有良好的导热和导电性能,热匹配性能良好。