烧结银可以解决现有存在的五个难题
总所周知,不论是碳化硅模块还是硅IGBT,电力电子发展总体目标是提高功率(电流,电压)——降低半导体控制和开关时损耗——扩展工作温度的范围——提高使用寿命,稳定性和可靠性——在降低失误率的同时简化控制和保护电路到后的降低成本。
目前尽可能从机械方面集成电力电子系统所有的功能,碳化硅、氮化镓(射频/非射频)模块封装也向着更高的集成度方向发展。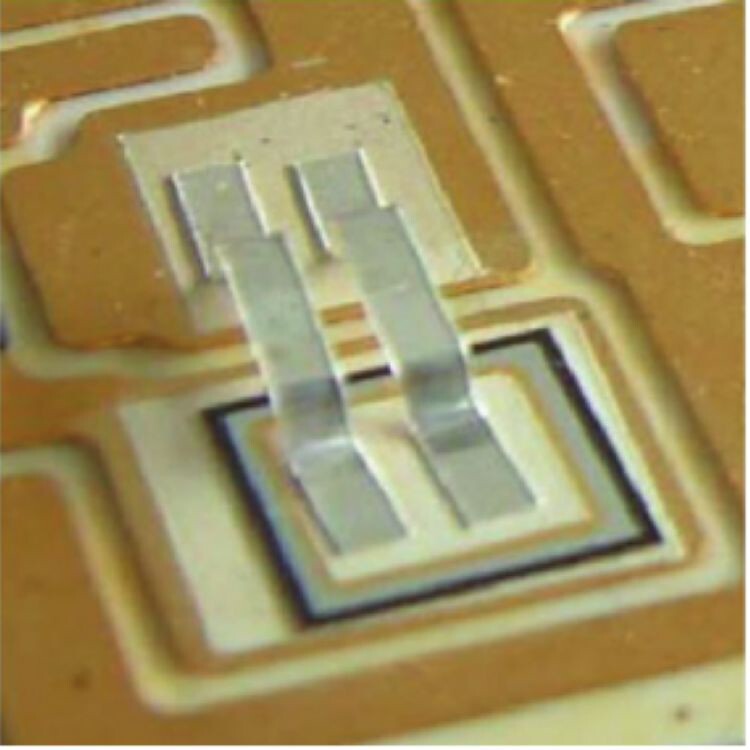
烧结层厚度较焊接层厚度薄60-70%,热传导率提升5倍,国内外诸多厂商把银烧结技术作为第三代半导体封装的核心技术,银烧结技术成为芯片与基板之间连接的选择.
芯片连接采用银烧结合金而不是焊接,烧结连接熔点更高,这意味着在给定温度摆幅下连接的老化率将低得多,功率模块的热循环能力可增加5倍。
连接温度和辅助压力均有明显下降,扩大了工艺的使用范围。在银烧结技术中,为了防止氧化和提高氧化层的可靠性,
在银烧结技术中,为了防止氧化和提高氧化层的可靠性,需要在基板裸铜表面先镀镍再镀金或镀银,同时烧结温度控制和压力控制也是影响功率模组质量的关键因素。