DTS+TCB焊片DTS+TBC工艺四川DTS
-
¥1200.00
及时发货
交易保障
卖家承担邮费
DTS+TCB预烧结银焊盘工艺提高功率器件通流能力和功率循环能力
在新能源汽车、5G通讯、光伏储能等终端应用的发展下,SiC/GaN等第三代半导体材料水涨船高,成为时下火爆的发展领域之一。
单管封装中引入扩散焊“Diffusion Soldering”,省了芯片与lead frame之间的焊料,优化了器件热阻。以1200V/30mOhm的SiC MOSFET单管为例,基于GVF预烧结银焊片,相比当前焊接版的TO247-3/4L,可降低约25%的稳态热阻Rth(j-c),和约45%的瞬态热阻。
功率半导体是电子装置中电能转换与电路控制的核心,主要用于改变电子装置中电压和频率、直流交流转换等。可分为功率IC和功率分立器件两大类,二者集成为功率模块(包含MOSFET/IGBT模块、IPM模块、PIM模块)。随着电力电子模块的功率密度、工作温度及其对可靠性的要求越来越高,当前的封装材料已经达到了应用极限。
GVF预烧结银焊片(DTS+TCB(Die Top System +Thick Cu Bonding)不仅能显著提高芯片连接的导电性、导热性,以及芯片连接的可靠性,并对整个模块的性能进行优化,还能帮助客户提高生产率,降低芯片的破损率,加速新一代电力电子模块的上市时间。
GVF预烧结银焊片(DTS+TCB(Die Top System +Thick Cu Bonding))能够将电力电子模块的使用寿命延长50多倍,并确保芯片的载流容量提高50%以上。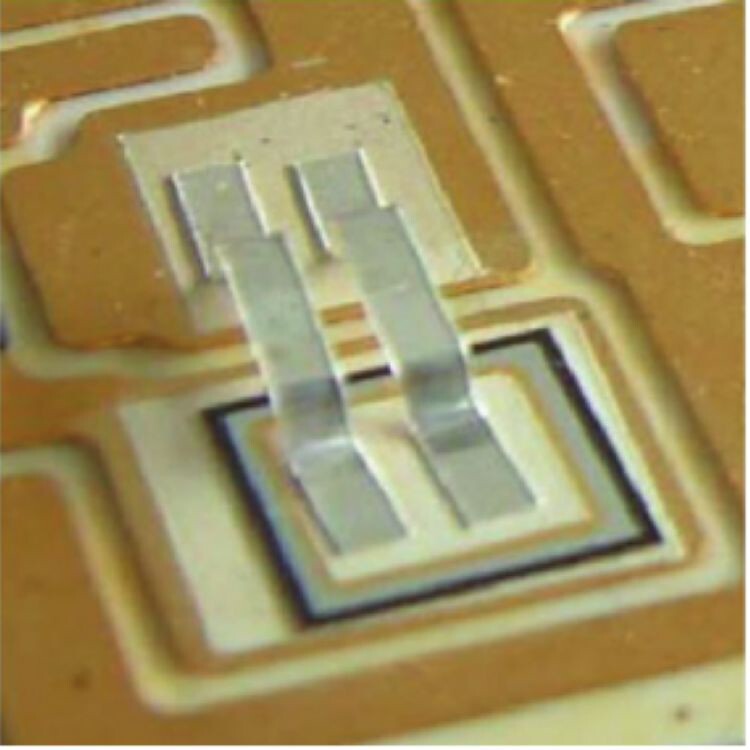
GVF预烧结银焊片(DTS+TCB(Die Top System +Thick Cu Bonding)的使用方法为:Pick & Place;