长沙销售晶圆挑片器半导体扶梯
-
面议
现有晶圆片生产过程中,需要从一道生产工序转移到下一道生产上,现有技术中依靠人力进行传送,传送过程的耗费人力,且人为传送力道不能掌握,容易造成破片。为此,我们提供了一种自动晶圆传片器以解决以上问题。
通过设置设备箱体、卡匣定位结构、检测机构和推料机构,使得在晶圆片传送时能够通过卡匣定位结构对卡匣进行定位,然后再通过检测机构检测卡匣内晶圆片的位置,避免晶圆片错位,后通过推料机构实现卡匣的传送,整个传送过程简单、易操作,实现自动化传片,且能够对晶圆片进行检测避免晶圆片错位造成传片损坏。
为了保护晶圆在切割过程中免受外部损伤,事先会在晶圆上贴敷胶膜,以便更安全的“切单”。“背面减薄”过程中,胶膜会贴在晶圆的正面。但与此相反,在“刀片”切割中,胶膜要贴在晶圆的背面。而在共晶贴片,把分离的芯片固定在PCB或定架上过程中,贴会背面的这一胶膜会自动脱落。切割时由于摩擦很大,所以要从各个方向连续喷洒DI水(去离子水)。而且,叶轮要附有金刚石颗粒,这样才可以更好地切片。此时,切口(刀片厚度:凹槽的宽度)均匀,不得超过划片槽的宽度。
晶圆切割时,经常遇到较窄迹道(street)宽度,要求将每一次切割放在迹道中心几微米范围内的能力。这就要求使用具有高分度轴精度、高光学放大和对准运算的设备。当用窄迹道切割晶圆时,应选择尽可能薄的刀片。可是,很薄的刀片(20um)是非常脆弱的,更容易过早破裂和磨损。结果,其寿命期望和工艺稳定性都比较厚的刀片差。对于50~76um迹道的刀片推荐厚度应该是20~30um。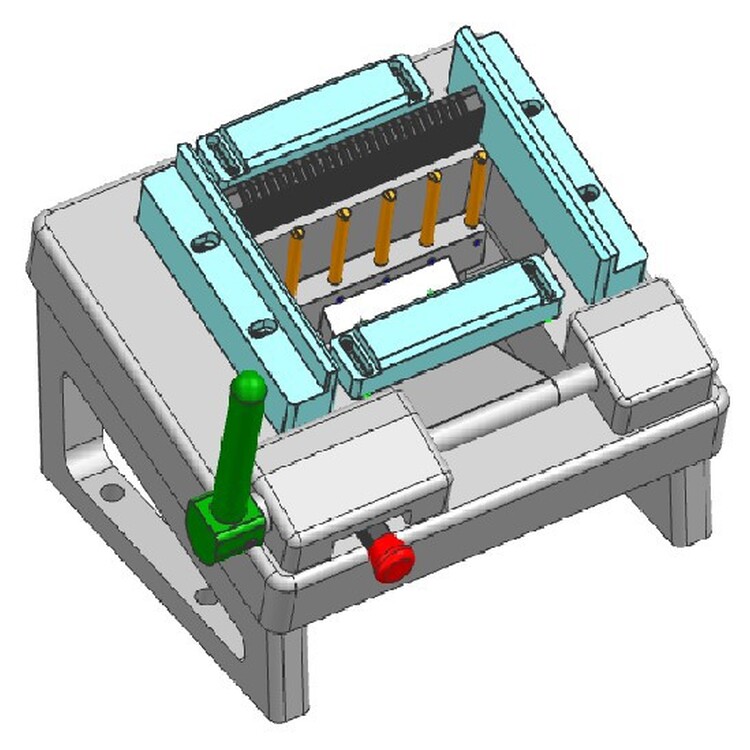
在切片或任何其它磨削过程中,在不超出可接受的切削质量参数时,新一代的切片系统可以自动监测施加在刀片上的负载,或扭矩。对于每一套工艺参数,都有一个切片质量下降和BSC出现的极限扭矩值。切削质量与刀片基板相互作用力的相互关系,和其变量的测量使得可以决定工艺偏差和损伤的形成。工艺参数可以实时调整,使得不超过招矩极限和获得大的进给速度。
切片工序的关键部分是切割刀片的修整(dressing)。在非监测的切片系统中,修整工序是通过一套反复试验来建立的。在刀片负载受监测的系统中,修整的终点是通过测量的力量数据来发现的,它建立佳的修整程序。这个方法有两个优点:不需要来佳的刀片性能,和没有合格率损失,该损失是由于用部分修整的刀片切片所造成的质量差。
通常来说,对于小芯片减薄划片时使用UV膜,对于大芯片减薄划片时使用蓝膜,因为,UV膜的粘性可以使用紫外线的照射时间和强度来控制,防止芯片在抓取的过程中漏抓或者抓崩。若芯片在减薄划切实之后,直接上倒封装标签生产线,那么好使用UV膜,因为倒封装生产线的芯片一般比较小,而且设备的顶针在蓝膜底部将芯片顶起。如果使用较大粘性剥离度的蓝膜,可能使得顶针在顶起芯片的过程中将芯片顶碎。
蓝膜由于受其温度影响乃粘性度会发生变化,而且本身粘性度较高,因此,一般较大面积的芯片或者wafer减薄划切后直接进行后封装工艺,而非直接进行倒封装工艺做Inlay时,可以考虑使用蓝膜。
在芯片的分割期间,刀片碾碎基础材料(晶圆),同时去掉所产生的碎片。材料的去掉沿着晶方(dice)的有源区域之间的切割线(迹道)发生的。冷却剂(通常是去离子水)指到切割缝内,改善切割品质,和通过帮助去掉碎片而延长刀片寿命。每条迹道(street)的宽度(切口)与刀片的厚度成比例。