河南TSV小型晶圆喷镀台芯片,晶圆电镀机
-
面议
及时发货
交易保障
卖家承担邮费
在三维集成中 TSV 技术可分为三种类型:在 CMOS ⼯艺过程之前在硅片 上完成
通孔制作和导电材料填充的是先通孔技术;⽽中通孔,在CMOS制 程之后和后端
制程(BEOL)之前制作通孔。后⼀种后通孔技术是在 CMOS ⼯艺完成后但未
进⾏减薄处理时制作通孔。终技术⽅案的选择要 根据不同的⽣产需求。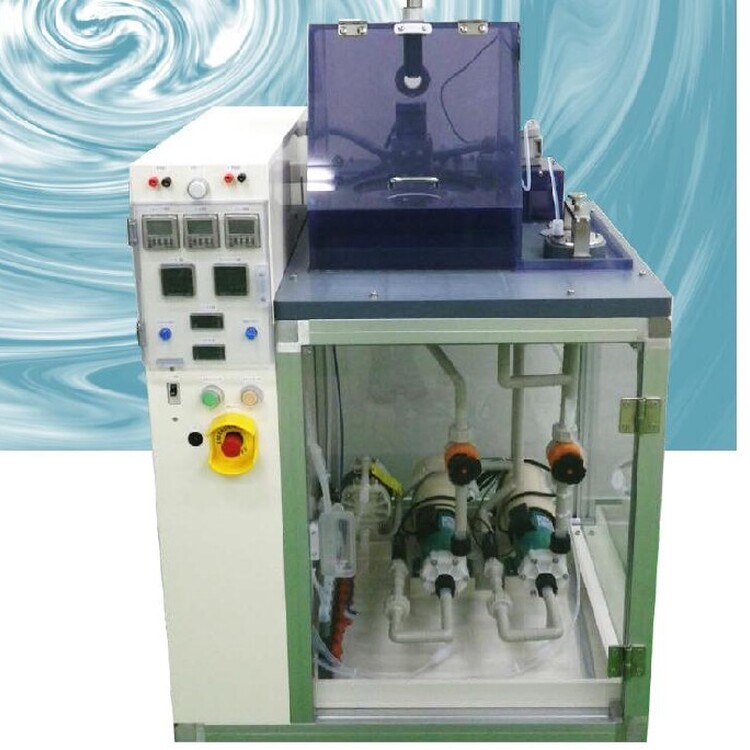
封装之TSV及TGV技术初探
其中,玻璃诱导刻蚀法如下:
1) 使用皮秒激光在玻璃上产⽣变性区域;2)将激光处理过的玻璃放在 氢氟酸溶液
中进⾏刻蚀。
嵌⼊式玻璃扇出与集成天线封装
玻璃通孔还可以在玻璃上制作空腔,进⽽为芯片的封装提供⼀种嵌⼊ 式玻璃扇
出(eGFO)的新⽅案。2017年乔治亚理⼯率先实现了用于⾼I/O 密度和⾼频多芯
片集成的玻璃面板扇出封装。该技术在70um厚、⼤小为 300mm*300mm的玻璃
面板上完成了26个芯片的扇出封装,并有效的控 制芯片的偏移和翘曲。2020年
云天半导体采用嵌⼊式玻璃扇出技术开了 77GHz汽⻋雷达芯片的封装,并在此
基础上提出了⼀种⾼性能的天线封装 (AiP)⽅案。