车规芯片烧结银加压烧结银替代美国烧结银
-
¥89000.00
及时发货
交易保障
卖家承担邮费
烧结银可以解决现有存在的五个难题
总所周知,不论是碳化硅模块还是硅IGBT,电力电子发展总体目标是提高功率(电流,电压)——降低半导体控制和开关时损耗——扩展工作温度的范围——提高使用寿命,稳定性和可靠性——在降低失误率的同时简化控制和保护电路到后的降低成本。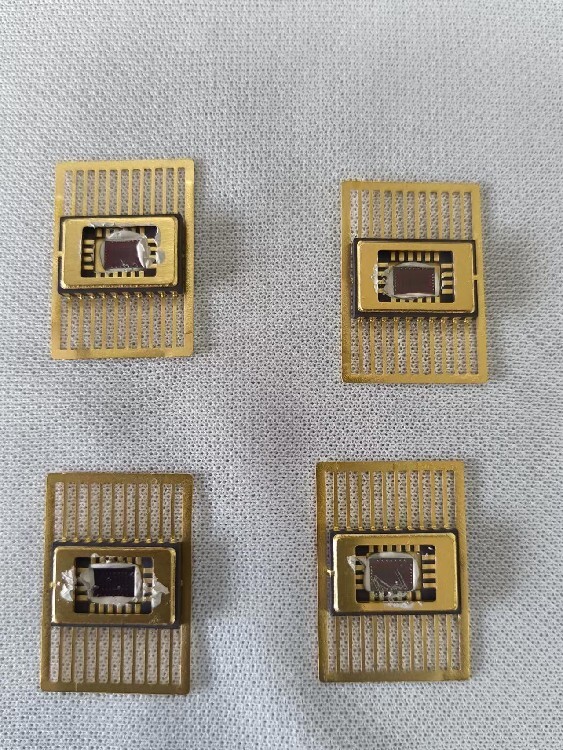
而在电动车辆中,电力电子器件节省空间、重量轻、并且即使在恶劣的条件下也要工作可靠。为了满足这些要求,传统基于模块的封装方式已经不能适应下游市场发展的需要,
个难题:烧结银膏技术
在芯片与基板的连接中,传统有基板焊接功率模块中,焊接连接往往是模块上的机械薄弱点。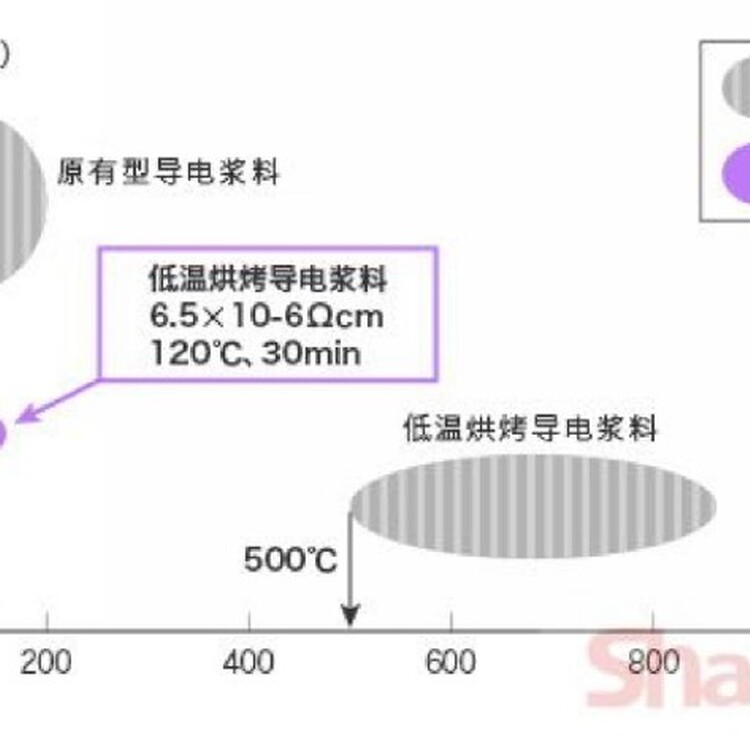
由于材料的热膨胀系数不同、高温波动和运行过程中的过度负载循环将导致焊料层疲劳,影响宽禁带半导体模块的可靠性。
相比焊接模块,加压烧结银的银烧结技术对模组结构、使用寿命、散热产生了重要影响,采用银烧结技术可使模块使用寿命提高5-10倍,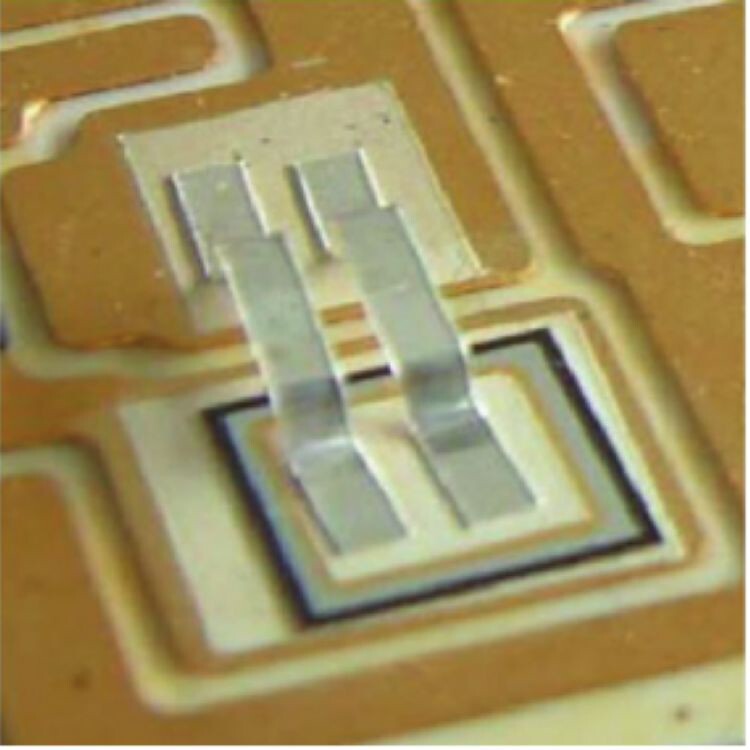
烧结层厚度较焊接层厚度薄60-70%,热传导率提升5倍,国内外诸多厂商把银烧结技术作为第三代半导体封装的核心技术,银烧结技术成为芯片与基板之间连接的选择.