DTS焊片DTS+TCB预烧结工艺四川DTS
-
¥1200.00
及时发货
交易保障
卖家承担邮费
终端应用市场对于率、高功率密度、节能的系统设计需求日益增强,与此同时,各国能效标准也不断演进,在此背景下,SiC凭借耐高温、开关更快、导热更好、低阻抗、更稳定等出色特性,正在不同的应用领域发光发热。
在成型技术也相当困难,由于电镀银是局部镀银,相较于全镀,部分镀银技术很难,做模具,且放置芯片处用局部银,一个导线架搭两个芯片,芯片局部银,其他引线框架用镍钯金,材料差异对引线框架制作是很大的技术挑战。
众所周知,在单管封装中,影响器件Rth(j-c)热阻的主要是芯片、焊料和基板。SiC芯片材料的导热率为370W/(m.K),远IGBT的Si(124W/(m.K)),甚至超过金属铝(220W/(m.K)),与Lead Frame的铜(390 W/(m.K))非常接近。而一般焊料的导热率才60 W/(m.K)左右,典型厚度在50-100um,所占整个器件内部Rth(j-c)热阻之权重,是不言而喻的。
功率半导体是电子装置中电能转换与电路控制的核心,主要用于改变电子装置中电压和频率、直流交流转换等。可分为功率IC和功率分立器件两大类,二者集成为功率模块(包含MOSFET/IGBT模块、IPM模块、PIM模块)。随着电力电子模块的功率密度、工作温度及其对可靠性的要求越来越高,当前的封装材料已经达到了应用极限。
GVF预烧结银焊片(DTS+TCB(Die Top System +Thick Cu Bonding)的使用方法为:Pick & Place;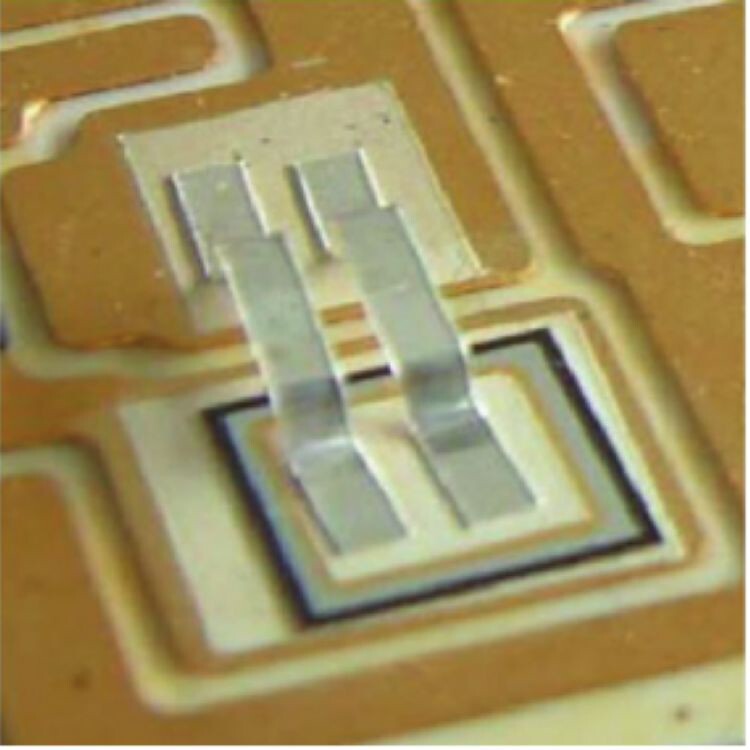
在能源效率新时代,SiC开始加速渗透电动汽车、光伏储能、电动车充电桩、PFC/开关电源、轨道交通、变频器等应用场景,接下来将逐步打开更大的发展空间。